
삼성전자가 기존 제품(HBM4) 대비 성능을 2.8배 끌어올린 고객 맞춤형(커스텀) 고대역폭메모리(HBM)를 출시한다. 그래픽처리장치(GPU)에 HBM을 수직으로 쌓아 연결하는 zHBM 개발에도 나섰다. HBM4를 가장 빨리 공급하며 쥔 첨단 메모리 주도권을 차세대 HBM으로 이어간다는 방침이다.
송재혁 삼성전자 최고기술책임자(CTO·사장)는 11일 서울 삼성동 코엑스에서 열린 ‘세미콘코리아 2026’에서 차세대 반도체 기술 로드맵을 공개했다.
대표 제품은 HBM이 GPU의 일부 연산 기능을 담당하도록 설계한 ‘삼성 커스텀 HBM’이다. 동일한 전력으로 성능이 2.8배 개선되는 만큼 ‘게임 체인저’가 될 제품이라고 회사는 설명했다. zHBM은 GPU 옆에 HBM을 두는 기존 방식과 달리 GPU 위에 HBM을 수직으로 쌓아 성능과 전력 효율을 끌어올린 제품이다.
송 사장은 “삼성 HBM4 기술은 업계 최고”라며 “HBM4E, HBM5 등 차세대 제품에서도 1위가 될 것”이라고 강조했다.
2.8배 성능 높은 커스텀 HBM 개발
종합 반도체사업자 장점 앞세워…기존 '틀' 깬 차세대 AI칩 공개

인공지능(AI) 서버의 핵심 부품인 AI 가속기를 평가하는 기준은 이제 연산 성능에 머무르지 않는다. 성능을 끌어올릴수록 발열이 늘고 전력 소모도 커지기 때문에 ‘전성비’(전력소모량 대비 성능)가 높은 반도체를 개발하는 게 새로운 ‘게임의 법칙’이 됐기 때문이다.
송재혁 삼성전자 반도체(DS)부문 최고기술책임자(CTO·사장)가 11일 AI 가속기의 핵심 반도체인 고대역폭메모리(HBM)와 관련해 커스텀(고객사 맞춤형) HBM, zHBM, 실리콘 포토닉스 등 기존의 틀을 깨는 신기술·제품을 들고 나온 이유가 여기에 있다. 메모리와 파운드리, 패키징 사업을 모두 아우르는 제조 역량을 총동원해 AI 시대에 최적화된 새로운 반도체 해법을 보여주겠다는 것이다.
◇ 연산하는 HBM 개발
송 사장은 이날 서울 삼성동 코엑스에서 열린 ‘세미콘 코리아 2026’에서 올 하반기 시장의 간판이 될 HBM4에 대한 자신감을 드러냈다. 이 칩의 가장 아랫단에 배치돼 두뇌 역할을 하는 베이스 다이는 삼성전자 파운드리 사업부의 4㎚(나노미터·1㎚10억 분의 1m) 공정으로 만들었다. 송 사장은 “베이스 다이의 성능을 개선한 덕분에 HBM4의 전력 효율성이 전작인 5세대(HBM3E) 제품보다 2배 높아졌다”고 말했다.
차세대 제품으로 각광받는 커스텀 HBM(cHBM) 개발 방향에 대해서도 언급했다. 커스텀 HBM은 고객사가 제시한 조건대로 만든 HBM을 말한다. 이 칩 역시 베이스 다이를 더욱 똑똑하게 만드는 게 핵심이다. 정보 기억장치 역할만 하는 것에서 벗어나 직접 연산을 하고 정보를 선별하면서 데이터 병목 현상을 최소화하겠다는 것이다. GPU와 HBM 간 연결 통로도 고객사가 원하면 길이를 더 짧게 만들 수 있다. 송 사장은 “기존 제품보다 GPU와 HBM 사이의 거리를 60% 줄이며 전력 당 정보 처리 성능이 2.8배 올라갔다”고 강조했다.
◇ GPU 위에 HBM 배치
HBM은 여러 개의 D램을 수직으로 쌓아올린 반도체다. 이 칩들을 나노미터 단위의 오차 범위 안에서 정교하게 쌓는 작업을 ‘패키징’이라고 한다. 송 사장 발표에선 이런 패키징 기술을 고도화한 zHBM이 소개됐다. 지금까지는 HBM을 AI 데이터를 연산하는 GPU 옆에 배치했지만, 이것은 GPU 위에 HBM을 올리는 것이 포인트다. GPU와 HBM 간 거리가 더욱 가까워져서 병목 현상이 줄고, 칩 사이즈도 줄어든다. zHBM의 데이터 전송 속도는 HBM4에 비해 4배 높다. 반면 동작에 필요한 전력은 4분의 1이나 아낄 수 있다고 송 사장은 설명했다.
칩과 칩을 가교(범프) 없이 곧바로 이어붙이는 하이브리드 본딩 패키징 공정을 활용한 16단 이상 HBM 개발에도 들어갔다. 기존 결합 방식인 열압착(TC) 본딩을 활용할 때보다 열 저항을 20% 가까이 줄일 수 있는 게 특징이다.
송 사장은 세계 파운드리(반도체 수탁생산) 1위 TSMC가 주름잡고 있는 실리콘 포토닉스(CPO) 기술 소개에도 시간을 할애했다. CPO는 전기 신호를 빛으로 바꿔 전달하는 기술인데, 반도체 기판 위에 빛 소자를 올리는 패키징 기술의 난도가 높은 것으로 알려졌다. 송 사장은 “기존 전기 회로 방식보다 전력 효율과 정보 이동 속도가 3배 올라간 걸 확인했다”고 말했다.
◇ VS D램, BV 낸드도 공개
칩 속에 있는 나노미터 단위의 기억 장치를 쌓는 기술도 주목받았다. 송 사장은 D램 기억 소자를 평면이 아닌 아파트처럼 쌓는 ‘수직적층(VS) D램’, 기억소자부와 페리(주변회로)를 따로 만들어서 하이브리드 본딩으로 결합하는 ‘BV(본딩버티컬)낸드’도 소개했다.
파운드리 공정에서 3㎚ 공정으로 만든 게이트올어라운드(GAA) 소자를 수직으로 쌓아올린 ‘3DSFET’도 주목할만한 신기술로 평가됐다. 이렇게 하면 평면에 모든 GAA 소자를 놓을 때보다 면적을 최대 32% 줄일 수 있다.
송 사장은 “D램, 낸드, 로직 반도체, 패키징 등 삼성의 모든 사업 분야에서 다양한 시너지가 나고 있다”며 “이런 시너지를 최대한 효율적으로 활용해 AI 시장이 요구하는 기능을 확보할 것”이라고 말했다.
김채연/박의명/강해령 기자 why29@hankyung.com

 1 month ago
14
1 month ago
14



![벌금이냐, 출장정지냐…'탈세 논란' 룰러의 운명은 [이주현의 로그인 e스포츠]](https://img.hankyung.com/photo/202604/01.43833025.1.jpg)
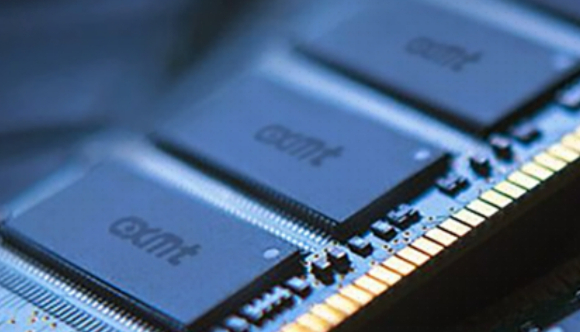

![[세상풍경] 평일에도 개방한 홍릉숲](https://img4.yna.co.kr/etc/inner/KR/2026/04/03/AKR20260403132400546_28_i_P4.jpg)
![넷플릭스 시리즈 '사냥개들', 시즌2로 돌아왔다 [콘슐랭]](https://image.inews24.com/v1/9e8c19df806ba6.jpg)







 English (US) ·
English (US) ·